在芯片制造領域,制程工藝一直被視為行業基石,其重要性不言而喻。然而,隨著半導體工藝復雜度日益提升,制程提升的空間逐漸收窄,而市場對芯片性能的追求卻從未停歇,特別是在AI時代的大潮中,這一矛盾愈發凸顯。
在此背景下,封裝技術的重要性逐漸浮出水面。它不僅能夠持續提升芯片性能,更為芯片制造帶來了前所未有的靈活性,使得理想芯片的打造成為可能,滿足多樣化市場需求。封裝技術,正逐步成為行業的新焦點。
Intel,作為半導體行業的領軍企業,半個多世紀以來始終致力于封裝技術的創新與演進。最近,Intel先進系統封裝與測試事業部的副總裁兼總經理Mark Gardner分享了Intel在封裝技術領域的最新成果與見解。
回溯歷史,在SoC單芯片時代,封裝技術并未受到過多關注。但隨著chiplets技術的興起,封裝技術的重要性日益顯著,芯片的復雜度和優化程度呈指數級增長。以AI加速器為例,一個封裝內可能集成多個芯片,包括CPU計算模塊、GPU加速模塊、HBM高帶寬內存等,它們需要以最優方式整合,實現高性能、低延遲的互聯。

Intel在封裝技術方面擁有深厚的歷史底蘊。從20世紀70年代的Wire-Bond引線鍵合封裝技術,到90年代的倒裝鍵合、陶瓷基板技術,再到近年來的EMIB 2.5D、Foveros 3D等先進技術,Intel的封裝技術經歷了多次革新。這些技術并非一蹴而就,而是長期積累的結果。例如,基于EMIB 2.5D的首個產品Kaby Lake-G已投產近十年,成為Intel與AMD合作的典范。
展望未來,Intel還在不斷探索新的封裝技術。玻璃基板(Glass Substrate)和玻璃核心(Glass Core)就是其中的代表。這些技術仍在推進中,計劃在本世紀20年代后半期推出,作為整體平臺的一部分。Intel認為,玻璃核心的關鍵在于持續擴展,包括微凸點技術、更大的基板尺寸、增強的高速傳輸等。

在新的市場形勢下,Intel Foundry代工服務增加了系統級架構和設計服務,與產品部門深度合作,不斷推出更先進、更高效的封裝技術,反哺產品設計與制造。例如,幾年前的數據中心GPU Max(代號Ponte Vecchio)就采用了多達5種不同制造工藝,封裝了47個不同模塊,耗資千億晶體管。
Intel的封裝技術組合十分豐富。傳統的FCBGA(倒裝芯片球柵陣列封裝)分為FCBGA 2D和FCBGA 2D+兩種版本,適用于不同需求。EMIB(嵌入式多芯片互連橋接)則分為EMIB 2.5D和EMIB 3.5D,前者適用于高密度芯片間連接,后者引入了3D堆疊技術,更加靈活。Foveros系列則包括Foveros 2.5D、Foveros 3D和Foveros Direct 3D,采用焊料連接芯片與晶圓,適合高速I/O與較小芯片組分離的設計。
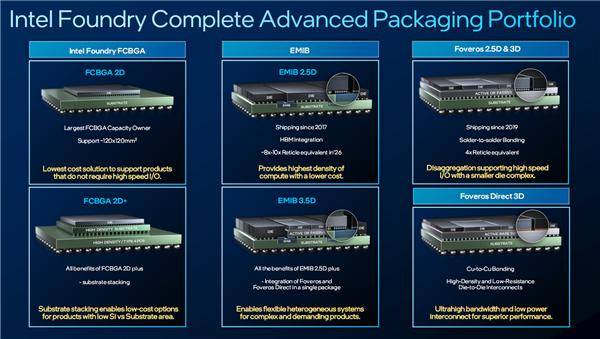
這些封裝技術并非停留在理論層面,而是已經落地商用,涉及多代產品。然而,如何為不同芯片選擇最適合的封裝技術仍是一大挑戰。以EMIB為例,其作為AI芯片的理想選擇,具有成本低、良率高、生產周期短等優勢。這些優勢源于EMIB橋接的小硅片設計,能夠高效利用晶圓面積,提高面板利用率,適應大型復雜封裝的需求。
Intel一直是2.5D封裝的領導者,擁有龐大的產能。第三方數據顯示,Intel EMIB 2.5D和Foveros 2.5D封裝的總產能遠超行業晶圓級先進封裝的總產能。迄今為止,Intel已完成超過250個2.5D封裝設計項目,涵蓋幾乎所有領域。Intel還開發了裸片測試和堆疊芯片測試技術,以確保封裝過程的可靠性和良品率。
在復雜封裝的測試和驗證方面,Intel同樣走在前列。通過將晶圓切割成單獨的裸片進行測試,Intel能夠在封裝前就發現缺陷并及時糾正,從而提高生產效率和良品率。這一技術使得過去只能在最終測試階段進行的工作得以提前,降低了整體風險。